【更小、更薄】美彩国际TSV封装为指纹模组带来革新
2016/04/13
美彩国际成功将直孔TSV的工艺应用到指纹识别芯片晶圆级封装,并与客户一起推出封装完成的芯片与模组。与苹果等厂商基于Trench + Wire Bonding的封装制程不同, 直孔TSV封装为指纹模组的可制造性带来革命性优势,减小模组尺寸,模组良率大幅提高,更适合手机工业的需求,以及满足下一代产品的新兴需求(更薄、更小、简化模组)。
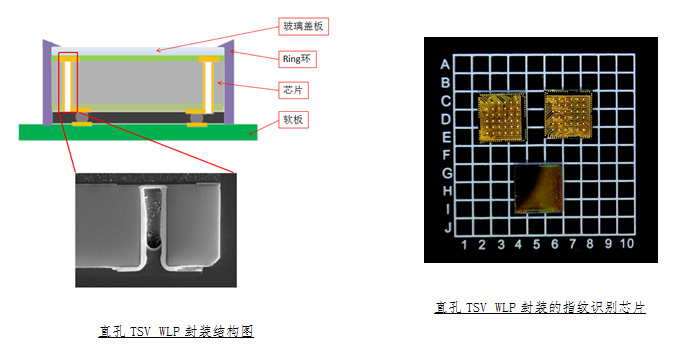
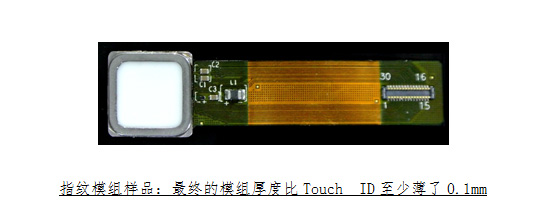
苹果Touch ID采用的单晶氧化铝磨厚度基本都在300um,再往下减薄将产生很多的技术问题,造成性价比难题,而美彩国际半导体采用的氧化锆陶瓷的硬度是8.5,单晶氧化铝(蓝宝石)是9,在耐磨性耐划性上是等价的;而氧化锆陶瓷的韧性高于单晶氧化铝6倍以上,这意味着更高的抗冲击抗震动能力;同时电学性能达到单晶氧化铝3倍以上,是非常理想的材料。作为人造宝石级仿钻的材料,其品味也不比人造蓝宝石材料差。所以基于美彩国际采用的TSV封装方案结合客户芯片的优秀算法可以把保护盖板厚度降低至200um以下,这是节省整体模组的厚度关键所在。
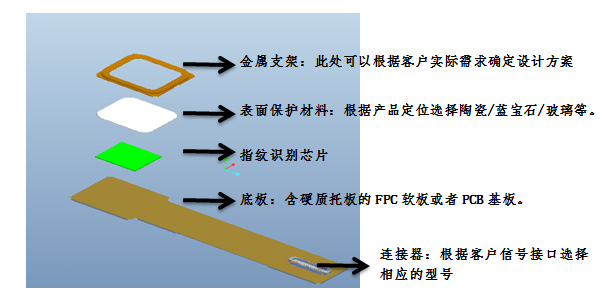
无论苹果的1.2mm还是美彩国际的超薄模组体,在保证机械强度的前提下,都是做到了极致。如果进一步降低厚度,则循环按压寿命将严重降低。
从指纹识别整体制程角度看,美彩国际半导体改良了设计和工艺,在现有的其他厂商模组设计的基础上,把trench + wire bonding转变为TSV + SMT,大幅度简化结构,从而极大提高良率和产能。在行业进入爆发式增长阶段时,将不受可制造性的限制,产能足以满足市场需求。
美彩国际半导体在指纹识别模组的设计标准中充分吸收了已有的指纹识别的优秀设计案例,并对其中不合理的部分进行了优化,从而在力学、电学、化学等方面均达到优秀水准。TSV的封装,Sensor的高集成度,将模组部件精简为5个,包括a. ring环; b.盖板;c. TSV packaged sensor;d. FPC;e. 托盘,竖向同轴组装,在小批量阶段全制程良率已经超过80%,有望迅速向95%以上突破。
从指纹识别整体制程角度看,美彩国际半导体改良了设计和工艺,在现有的其他厂商模组设计的基础上,把trench + wire bonding转变为TSV + SMT,大幅度简化结构,从而极大提高良率和产能。在行业进入爆发式增长阶段时,将不受可制造性的限制,产能足以满足市场需求。
美彩国际半导体在指纹识别模组的设计标准中充分吸收了已有的指纹识别的优秀设计案例,并对其中不合理的部分进行了优化,从而在力学、电学、化学等方面均达到优秀水准。TSV的封装,Sensor的高集成度,将模组部件精简为5个,包括a. ring环; b.盖板;c. TSV packaged sensor;d. FPC;e. 托盘,竖向同轴组装,在小批量阶段全制程良率已经超过80%,有望迅速向95%以上突破。


 中文
中文
 English
English 苏公网安备 32021402001899号
苏公网安备 32021402001899号