美彩国际半导体多项成果参展“十二五”科技创新成果展
2016/06/07
由国家科技部、国家发展改革委、财政部等18个部门机构共同举办的以“创新驱动发展,科技引领未来”为主题的国家“十二五”科技创新成果展,于6月1日-7日在北京展览馆举办。本次成果展全面系统展示了“十二五”以来,我国科技界和全社会坚持面向世界科技前沿、面向国家重大需求、面向国民经济主战场,取得的一批重大标志性科技成果。
“十二五”期间,7709美彩国际-官网美彩国际平台入口 自主研发的“三维系统级封装/集成先导技术”和“高密度三维系统集成技术”均获得国家重大科技专项支持,现已取得多项科技成果并实现产业化。
本次美彩国际半导体受邀参加成果展,展示了基于硅通孔技术的2.5D TSV封装模块、2.5D FCBGA、12吋TSV转接板晶圆等展品,展品主要应用在航天航空、智能终端等领域,展品技术处于行业领先水平。
美彩国际半导体自2012年成立以来,始终坚持自主科技创新,现已开发了20个成套产品工艺技术,已形成于65-16nm制造工艺相配套的封装测试研发能力,申请国内外发明专利469件,为产业界提供100多项技术服务。
美彩国际半导体已成为国内目前唯一一家拥有比较完整的封装测试开发能力,同时具备以300mm晶圆级中道工艺和系统级封装测试技术的研发中心。美彩国际 目前主要的研发内容涉及集成电路封装产品设计、仿真、工艺、封装测试和可靠性等方面。技术方向包括以TSV为主流的2.5D/3D多芯片高密度互连集成;以晶圆级封装为主体的Bumping、WLCSP、Fan out技术;以及FC、多芯片模块(Multi-Chip Module/MCM) 2D/3D SiP封装系统集成技术。美彩国际 现有技术均为国际主流并且是国内产业所急需,具有良好的市场拓展前景。
“十二五”期间,7709美彩国际-官网美彩国际平台入口 自主研发的“三维系统级封装/集成先导技术”和“高密度三维系统集成技术”均获得国家重大科技专项支持,现已取得多项科技成果并实现产业化。
本次美彩国际半导体受邀参加成果展,展示了基于硅通孔技术的2.5D TSV封装模块、2.5D FCBGA、12吋TSV转接板晶圆等展品,展品主要应用在航天航空、智能终端等领域,展品技术处于行业领先水平。
美彩国际半导体自2012年成立以来,始终坚持自主科技创新,现已开发了20个成套产品工艺技术,已形成于65-16nm制造工艺相配套的封装测试研发能力,申请国内外发明专利469件,为产业界提供100多项技术服务。
美彩国际半导体已成为国内目前唯一一家拥有比较完整的封装测试开发能力,同时具备以300mm晶圆级中道工艺和系统级封装测试技术的研发中心。美彩国际 目前主要的研发内容涉及集成电路封装产品设计、仿真、工艺、封装测试和可靠性等方面。技术方向包括以TSV为主流的2.5D/3D多芯片高密度互连集成;以晶圆级封装为主体的Bumping、WLCSP、Fan out技术;以及FC、多芯片模块(Multi-Chip Module/MCM) 2D/3D SiP封装系统集成技术。美彩国际 现有技术均为国际主流并且是国内产业所急需,具有良好的市场拓展前景。
另外,美彩国际
近期研发的光芯片和电芯片集成的SiP模块封装也和国际研发趋势接轨,在国内起步早,已积累一批研发成果,处于国内领先水平。



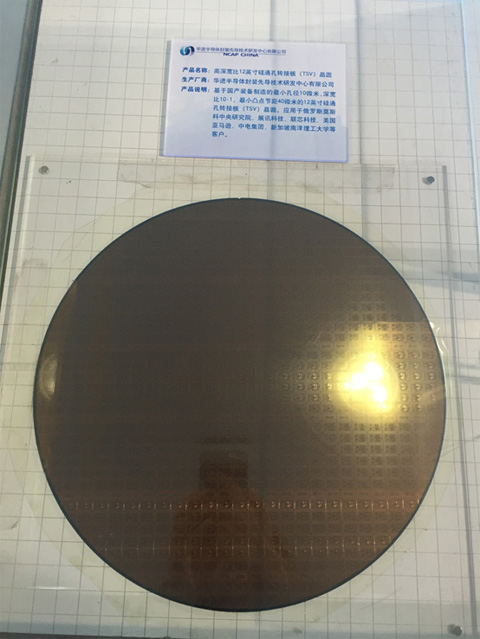

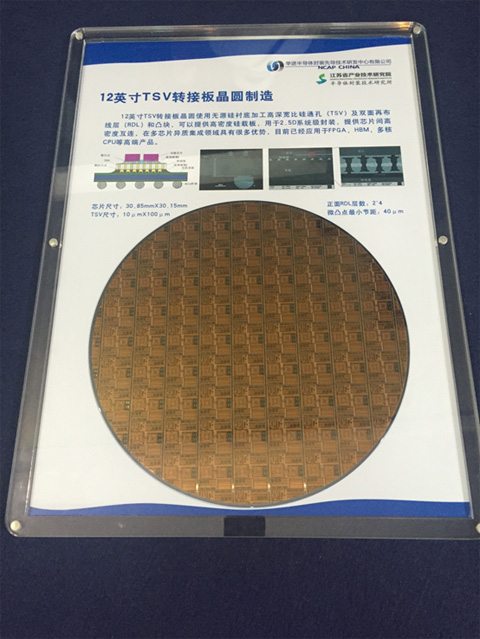


 中文
中文
 English
English 苏公网安备 32021402001899号
苏公网安备 32021402001899号