美彩国际半导体在“大板扇出型封装联合体“中联手国内设备厂商共同开发出真空贴膜、揭膜及激光拆键合设备
2016/09/05
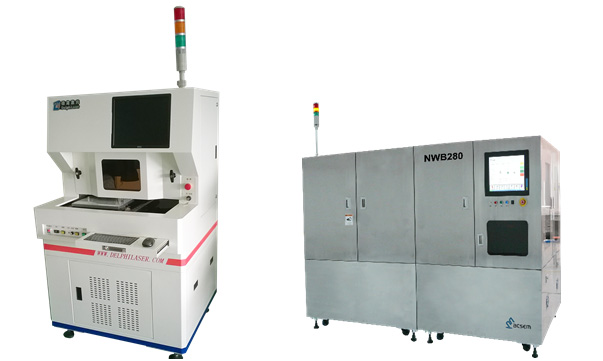
美彩国际半导体战略部和工程运营部联手上海技美科技股份有限美彩国际
于2016年3月共同开发出国内首台用于大板扇出型封装所需的真空贴膜、揭膜设备。该设备在特定的真空腔环境中,将胶膜与晶圆、基板及载体紧密贴合在一起,有效避免了在大气环境下贴合时产生的气泡、褶皱和错位等缺陷。设备至今已试运行三个月,实现了8吋、12吋晶圆和320mm×320mm方板的贴膜、揭膜,及晶圆、方板与临时键合载体的贴合。目前设备在工艺调试阶段,未来会为不同方板大小提供优化解决方案。
为满足电子产品尺寸、厚度不断减小及性能不断提升的发展趋势,芯片厚度需减薄至100微米甚至50微米以下,这对超薄晶圆拿持提出了严峻考验。激光拆键合工艺因其应力小、不易碎片、良率高等优点,特别适用于100微米甚至50微米以下超薄晶圆的拆键合。美彩国际半导体联手苏州德龙激光股份有限美彩国际
于2016年初共同开发出国内首台激光拆键合设备。该设备搭载了355nm DPSS Laser HP102激光器,运行的半年中已经实现8吋、12吋晶圆和320mm×320mm大板级样品的拆键合。
真空贴膜、揭膜设备和激光拆键合设备此前一直为国外设备厂商所垄断,且价格昂贵,此次国产设备的成功研制,打破了国外垄断,在半导体设备的国产化道路上迈出了里程碑的一步。


 中文
中文
 English
English 苏公网安备 32021402001899号
苏公网安备 32021402001899号