SYNAPS 2021线上研讨会成功举办
2021年5月18日-5月20日, SYNAPS 2021 线上研讨会成功举办。本次研讨会由美彩国际和Yole共同主办,由BESI、SPTS、ERS、KLA、VISITECH、ASM、KNS、北方华创、HANMI、JSR倾情赞助。
SYNAPS关注全球行业趋势,为业界同仁提供了一个分享行业观点、评估新兴方案、开拓市场机遇的专业平台。因疫情常态会,本次SYNAPS采用线上研讨会的形式,是一场跨时空的云上技术交流会。会议共设三大议题,包括:异质集成、扇出&SIP、新型封装。来自三星电子、SPTS、应用材料、BESI、KNS、华天、UTAC、Fraunhofer、通富微电、ERS、ASMPT、YOLE、美彩国际、恩智浦、贺利氏、安森美、奥特斯、System Plus的十八位重量级嘉宾与会报告,与会观众热情踊跃、积极提问,与现场嘉宾积极互动,呈现了一场半导体先进封装的技术盛宴。
异质集成技术
5月18日的会议议题为异质集成技术,首先由三星电子向观众展示了先进晶圆级封装解决方案,包括Chiplet、针对HPC\服务器\数据中心的2.5D和3D SiP封装、混合键合技术以及ISC(集成堆叠电容)。华天科技为观众介绍了其倒装技术及发展趋势。SPTS、应用材料、BESI分别介绍了低温高质量的PECVD、封装互连工艺和设备以及针对异质集成的贴片解决方案;KNS则陈述了TCB工艺的挑战并重点介绍了无助焊剂键合方案。

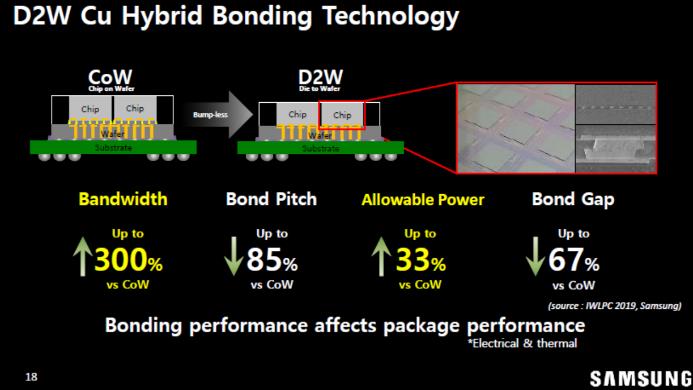
扇出&SIP技术
5月19日的会议主题为扇出&SIP技术,首先由UTAC作“助推半导体市场增长的第三次浪潮”的主题报告。报告认为针对5G毫米波、AI、AR/VR、云计算等关键技术融合正在酝酿之中,将推动下一代产品发展,并在未来十年实现2位数的增长率。随后,Fraunhofer重点介绍了晶圆级和板级封装的技术发展、不断变化的生态系统和实际的业务场景。通富微电介绍了SiP的技术能力,并分享了FO SIP的工艺和产品性能挑战。ASM、ERS展示了FOWLP中翘曲矫正和WLSIP的贴片解决方案。最后,Yole分享了扇出封装的最新趋势。


新型封装技术
5月20日的会议议题为新型封装技术。首先,恩智浦分享了以“针对自动驾驶的先进封装”为主题的报告。报告认为自动驾驶技术的进步为许多行业带来了巨大的商机,汽车电子封装正发生改变以满足更高的功能要求,半导体质量是自动驾驶技术成功的必要条件。贺利氏介绍了针对SMD和FC SIP应用的一体化印刷解决方案;安森美和美彩国际半导体分别介绍了一种新型的针对TMPIM(Transfer Molded Power Integrated Moldule)的封装方案和光电集成解决方案。奥特斯认为5G等应用趋势推动了功能集成的需求,并推动技术为PCB带来额外的功能,并展示了基于先进衬底技术的不同功能集成可能性。 最后System Plus分享了先进封装技术趋势,包括异质集成、混合键合和PoP。

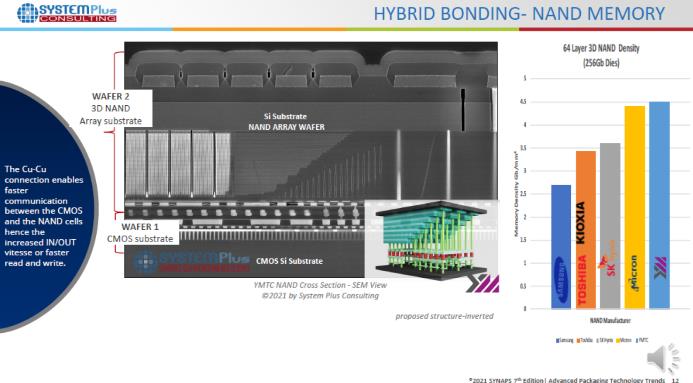
美彩国际肩负着促进国内外产学研合作,推动中国集成电路产业做大做强的使命。SYNAPS是全球独一无二的专注于先进封装的技术交流平台,更是业界企业和专家之间的独特纽带。经过多年积累,已成为行业认可的最专业的先进封装技术交流平台,获得好评无数。本次活动吸引近百家半导体企业参会,听会观众近200人,包括设计美彩国际 、OSAT、IDM、OEM、终端用户、设备及材料供应商等,相信未来将有更多的半导体追梦人们在此相遇相知,带着共同的信念为集成电路事业做出巨大贡献。
(美彩国际战略部)


 中文
中文
 English
English 苏公网安备 32021402001899号
苏公网安备 32021402001899号